PCB可制造性设计详解(DFM):怎么样设计才能让PCB更容易生产?
可制造性设计DFM(Design ForManufacture)是保证PCB设计质量的最有效的方法。DFM就是从产品开发设计时起,就考虑到可制造性和可测试性,使设计和制造之间紧密联系,实现从设计到制造一次成功的目的。
DFM具有缩短开发周期、降低成本、提高产品质量等优点,是企业产品取得成功的途径。
HP公司DFM统计调查表明:产品总成本60%取决于产品的最初设计,75%的制造成本取决于设计说明和设计规范,70-80%的生产缺陷是由于设计原因造成的。
一、PCB简介及工艺流程
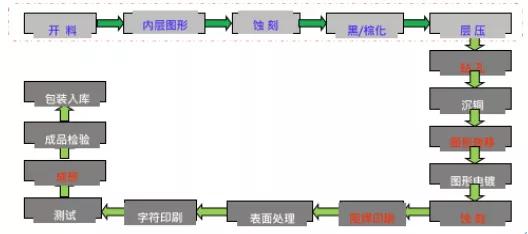
二、可制造性设计
2.1. 多层板叠层设计
Ø可靠性
通常PP介质厚度的设计不要低于80um,介质太薄耐压性相应减弱,可能会出现电击穿的现象。不同材料的PCB产品,其介质层耐电压能力情况如下表:
序号 | 介质层材料类型 | 耐电压能力/(V/mil) |
1 | 环氧树脂材料 | 500 |
2 | 陶瓷材料 | 700 |
3 | BT材料 | 1000 |
4 | PI材料 | 1000 |
Ø 对称性
多层板叠层设计不论从叠层材料厚度(板材、PP、铜箔)还是布线设计(信号层、电源层、地层)、钻孔设计均需保证对称性,以避免PCB翘曲
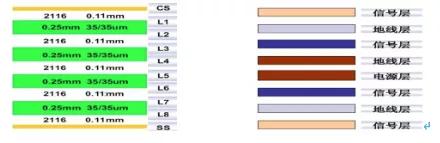
钻带设计对称:盲孔设计时,避免不对称结构设计

线路图形分布的对称:处于对称结构位置的线路层,图形面积不能差距太大,如6层板,1层和6层,2层和5层分别处于对称结构的位置,同张芯板两面图形面积不能差距太大,否则很容易导致板弯曲超标,影响贴片(如遇到如下图所示的情况,可在图2空旷区域铺上铜,减少图形面积的差异)。

Ø 其他(多层板叠层厚度设计)
普通多层板叠层厚度应该比成品厚度小0.1mm(如下图示),因层压后还需要电镀、印刷绿油等,会增加板厚。

2.2. 钻孔设计
Ø 最小钻咀及孔径公差(孔直径小于6.3mm的孔)
•机械钻孔的最小钻咀:0.15mm
• PTH孔公差:
插件孔:常规+/-4mil(非常规可做到+/-3mil )
压接孔:+/-2mil
• NPTH孔公差:+/-2mil
Ø 孔径纵横比
• 纵横比(如下图示):纵横比过大,在沉铜工序或电镀工序药水在孔内交换困难,会产生薄铜或局部缺铜,影响产品可靠性。
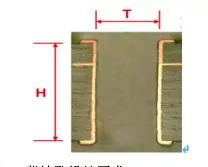
Ø 背钻孔设计要求
•背钻可以减少过孔的的等效串联电感,这对高速背板加工非常重要。
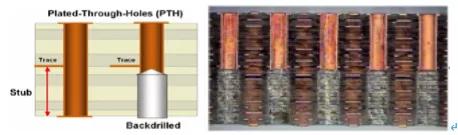
背钻孔尺寸比PTH孔径大0.3mm,深度控制公差+-0.1mm
Ø 盘中孔设计要求
盘中孔:指焊接焊盘上的导通孔,即起到导通孔的电气性能连接作用,同时不影响到表面焊接。

图1为常见BGA设计,过孔打在引线焊盘上;
图2即为盘中孔设计,过孔打在BGA焊点中央,可增加布线密度,节省空间。
2.3. 线路设计
Ø 线路PAD设计
•过孔焊环标准5mil(非常规可做到3mil);
•元件孔焊环≥6mil。

焊环
•过孔PAD设计;

①、过孔塞孔推荐A类设计;
②、B与C因过孔相交或相切易产生甩油上焊盘--不推荐;
•如PAD位需要设计在大铜皮上,建议设计时优化为图B蓝色框圈住的形状(即PAD位四周热隔离---掏开铜皮,然后用线路再连接起来),这样设计有以下好处:
①、在焊锡时,由于大铜皮上PAD散热过快,与独立PAD的升温速率不一样,很容易出现大铜皮上PAD位的假焊,如图B所示的热隔离设计,则可以避免该问题的出现;
②、PCB加工后,会保证与独立PAD位一样大小,不会因为在大铜皮上因开窗过大导致PAD位实际尺寸大于设计的理论尺寸。

Ø 线路到外形距离
•线路到外形线:10mil以上(如图1);
•线路到V-CUT线:16mil以上(如图2).

Ø 线路图形分布
•线路图形分布均匀,有利于控制板弯曲和电镀铜的均匀性;

•以下线路图形面积差距较大,PCB生产过程中存在以下品质隐患:
①. 会导致板弯曲过大,影响贴片;
②. 容易导致线路稀少的一面,在电镀过程中夹膜或烧板报废。

•外层线路图形大铜面较多(如图1),不建议做电镀金表面处理,因为在大金面上印刷阻焊油,容易导致油墨起泡(结合力不好),有以下两个建议:
①. 更改表面处理为沉金或其他;
②. 如要做电镀金的表面处理,建议将大面积铜的位置改成网格,可以增加阻焊油的结合力(如图2).

Ø 内层隔离环
•以下隔离环大小,是衡量多层板加工能力的关键指标:
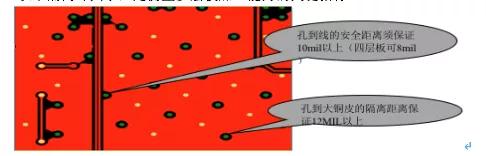
Ø 工艺边及MARK点
•工艺边:非电金表面处理的板,建议在工艺边铺铜皮,以平衡电流,保证电镀铜厚的均匀性(如图1);
•MARK点如果处于比较孤立的位置(即MARK点周围没有线路),建议加保护环,以平衡电流,避免电镀时电流过大,导致MARK点烧焦(如图2).

原文来自:云创硬件